(IBSD, engl. ion beam sputter deposition)

UHV-Ionenstrahlsputteranlage IonSys1600 zur Nanometer-Präzisionsbeschichtung und -ätzung
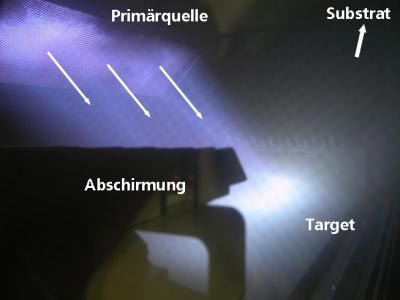
IBSD-Prozess mit Blick auf den primären Ionenstrahl für die Targetzerstäubung
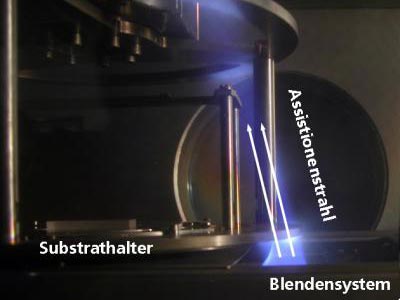
IBSD-Prozess mit Blick auf den sekundären Ionenstrahl für die Substratbehandlung (Reinigung, Glättung, Konturierung)
Prinzip der Schichterzeugung
- Generierung gerichteter Ionenstrahlen in den Ionenquellen
- Zerstäubung des Targetmaterials durch Stoßprozesse zwischen den Teilchen der primäre Ionenquelle und den Targetatomen
- Kondensation der zerstäubten Teilchen auf der Substratoberfläche
Prozessbedingungen
- Vakuum: p ~ 2 x 10-8 mbar
- Ionenquellen: primär für Targetzerstäubung, sekundär für Beeinflussung des Schichtwachstums (Assistbetrieb) oder Oberflächenmodifikation des Substrates (Reinigung, Glättung)
- Anregungsprinzip der Ionenquellen: Elektonenzyklotronresonanz (ECR)
- Anzahl der Targets: 6
- Targetgröße: 400 mm x 200 mm
- Substratgröße: schleusbar bis zu einem Durchmesser von 200 mm, größere Substrate bis zu einem Durchmesser von 500 mm werden per Hand über die Kammertür bestückt
Vorteile der IBSD mit linearen Ionenquellen
- große Flexibilität der Beschichtungsparameter
- gute Eignung für reaktive Sputterprozesse
- Schichten mit geringsten Defektdichten
- extrem glatte Schichten
- einfache Skalierbarkeit auf größere Substratgeometrien
- großflächig homogene Beschichtungen
Einsatzgebiete
- Herstellung ultraglatter Präzisionsschichten
- EUV-Reflexionsschichten auf nicht perfekt glatten Substratoberflächen
- Multischicht-Synchrotronoptiken
- Nanometer-Multischichten für Labor-Röntgenoptiken
- Wärmedämmschichten (ZrO2, ...)
- XUV-Reflexionsschichten
- Monochromatoren für die Röntgenfluoreszenzanalyse
- dielektrische Multischichten mit hoher Zerstörschwelle (SiO2/TiO2, SiO2/Al2O3, , ...)
- diamantartige Kohlenstoffschichten (DLC)
 Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS
Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS