Schwarzschildobjektive für extrem ultraviolette (EUV) Strahlung

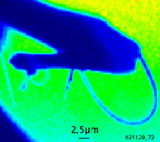

Problem
Für den Aufbau optischer Geräte wie z. B. Mikroskope für den EUV-Bereich müssen Reflexionsoptiken eingesetzt werden, da keine Materialien mit einer ausreichend geringen Absorption verfügbar sind. Um eine fehlerarme optische Abbildung realisieren zu können, sind im Allgemeinen asphärische Substrate notwendig. Eine interessante Alternative ist das von Schwarzschild entwickelte Konzept zur Kombination zweier sphärischer Optiken. Die zu lösenden Probleme hinsichtlich der Beschichtung mit EUV-Reflexionsschichten sind:
- hohe Reflexion der Schichten für eine lichtstarke Gesamtoptik
- Notwendigkeit geringster Eigenspannungen der Schichten um eine Deformation der Substrate zu vermeiden,
- Realisierung steiler und präziser Schichtdickengradienten auf dem konvexen Spiegel der Schwarzschildanordnung,
- Abstimmung der Beschichtungen beider Spiegel auf die gleiche EUV-Wellenlänge λ (sogenanntes λ-matching)
- sehr gute Langzeitstabilität
Lösung
Zur Beschichtung der Spiegel werden hochpräzise Sputterverfahren eingesetzt. Bei ausreichend glatten Substraten (rms-Mikrorauheiten < 0,3 nm) kommt die Magnetron-Sputter-Deposition zum Einsatz. Ist die Mikrorauheit der Substratoberflächen größer, wird durch den Einsatz der Ionenstrahl-Sputter-Deposition (IBSD) ein höherer Reflexionsgrad erreicht, da aufgrund der höheren kinetischen Energie der schichtbildenden Teilchen bei der IBSD eine Glättungswirkung erzielt wird.
Auch auf dem Gebiet der Beschichtung steiler Schichtdickengradienten auf stark gekrümmten Substaten sind in den letzten Jahren große Fortschritte erzielt worden. Durch den Einsatz einer vom IWS Dresden patentierten Maskentechnik ist es möglich, sehr steile Gradienten mit höchster Präzision abzuscheiden. Die Entwicklung und Kontrolle der Schichtdickenprofile erfolgt am EUV-Laborreflektometer des IWS Dresden.
Neben den Optiken ist auch die Halterung und Justage der Optiken wichtig für die einwandfreie Funktion des Objektivs. Je nach Anforderung wird der feinmechanische Aufbau an die experimentellen Gegenheiten angepasst. Die Spiegel des Objektivs können zueinander mit 3 Freiheitsgraden justiert werden. Durch Einsatz von Piezomotoren wird dabei die notwendige hohe Präzision erreicht und die Justage kann unter Vakuum erfolgen.
Anwendungen
Schwarzschildobjektive kommen in den folgenden Gebieten als EUV-Optiken zum Einsatz:
- Lithographie
- Mikroskopie
- Spektroskopie
- Metrologie
- Plasmaphysik
- Röntgenlaser
 Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS
Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS