Rückblick zur Nominierung von Trumpf, Zeiss und Fraunhofer für den Deutschen Zukunftspreis 2020
EUV-Lithographie öffnete Tür ins digitale Zeitalter
Die optische Lithographie gilt seit über 40 Jahren als Schlüsseltechnologie für die Fertigung von Mikrochips. Die neue Entwicklung hin zur EUV-Lithographie erweiterte die Grenzen des klassischen Verfahrens um ein Vielfaches. Das Fraunhofer Institut für Werkstoff- und Strahltechnik IWS trug mit dazu bei, dass nun die Fraunhofer-Gesellschaft, ZEISS und TRUMPF für den Zukunftspreis 2020 nominiert wurden. Das Projekt »EUV-Lithographie – Neues Licht für das digitale Zeitalter«, beschäftigt sich mit der Herstellungsmethode der neuesten EUV-Mikrochip-Generation. Auf dem Weg zu diesem Erfolg setzte das Fraunhofer IWS zusammen mit Fraunhofer IOF und Fraunhofer ILT in den vergangenen Jahrzehnten einige Meilensteine.
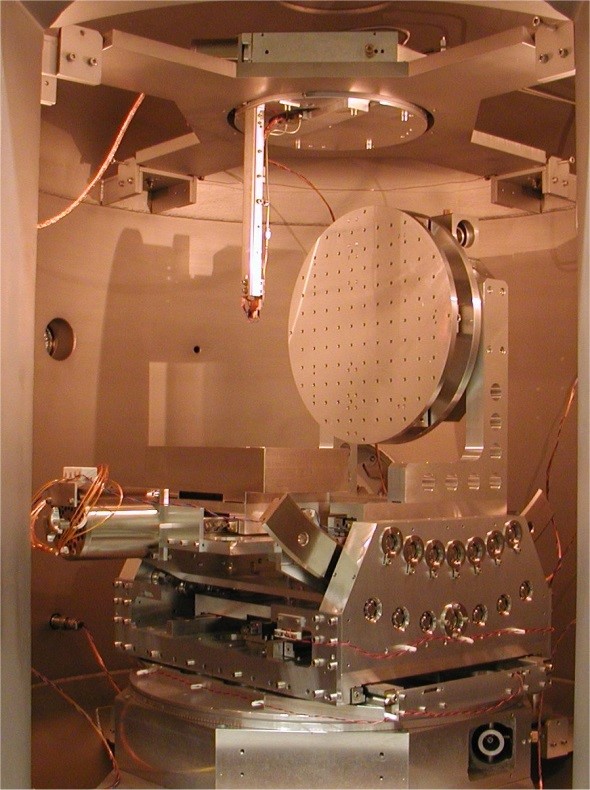
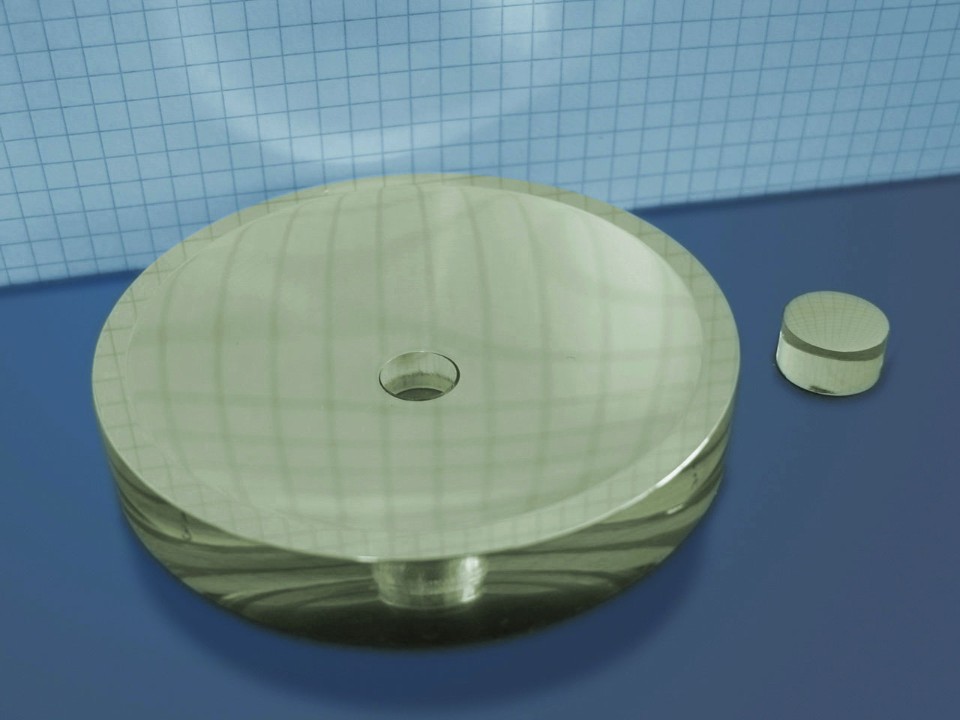

Die EUV-Lithographie blickt auf eine lange Geschichte bei der Fraunhofer Gesellschaft zurück. Die Technologieentwicklung mit dem kurzwelligen Licht basiert auf einer Gemeinschaftsarbeit: Im Fraunhofer-Verbund »Light and Surfaces« forschen Fraunhofer IWS, IOF und ILT gemeinsam an verschiedenen Teilaspekten der neuen Technologie, insbesondere an den notwendigen Optiken und Lichtquellen für die EUV-Strahlung. Das Fraunhofer IWS widmet sich dabei seit mehr als zwei Jahrzehnten der Herstellung der reflektierenden Optikbeschichtungen. EUV-Spiegel bestehen aus präzisen Nanometer-Multischichtsystemen, die Forscher auf große, komplex geformte Oberflächen aufbringen, stets mit dem Ziel, bestmögliche Reflexionsgrade und geringste Streuverluste zu erreichen.
Neue Techniken und erste Rekorde: Die Anfangszeit
Bereits in den 1990er-Jahren stellte das Fraunhofer IWS mit verschiedenen Beschichtungsverfahren Multischichtspiegel für den Röntgen- und EUV-Wellenlängenbereich her. Einen großen Meilenstein bei der Schichtentwicklung für EUV-Spiegel sieht Peter Gawlitza in der Einführung modernster Magnetron-Sputter-Beschichtungstechnik am Dresdner Institut im Jahr 2000. Der Gruppenleiter für EUV- und Röntgenoptik unterstreicht, dass es erstmals gelang, qualitativ hochwertige Schichtstapel präzise, reproduzierbar, extrem glatt und relativ schnell zu erzeugen. Das Forschungsteam, dem Gawlitza bereits damals angehörte, stellte damit 2001 erstmals Schichten mit einer EUV-Reflektivität von mehr als 70 Prozent her: damals der Weltrekord für EUV-Spiegel. Gawlitza unterstreicht: »Die Weltrekordschichten sind natürlich unter idealisierten Laborbedingungen auf kleinen, ebenen Modellproben entstanden. Für reale Anwendungen spielen weitere Faktoren wie thermische Stabilität oder komplexe Spiegelgeometrie eine Rolle, sodass sich diese Werte nicht für alle Anwendungsfälle erreichen lassen. Trotzdem sind Reflexionsbestwerte immer ein wichtiges Indiz für die Qualität des Beschichtungsprozesses.« Auch in den Folgejahren sollte das Institut mit stetigen Fortentwicklungen des Beschichtungsverfahrens weitere Rekorde feiern.
Erstes EUV-Labor-Reflektometer in Europa
Für die Schichtentwicklung spielt auch die Vermessung der optischen Eigenschaften der Spiegel bei der Anwendungswellenlänge eine wichtige Rolle. Dafür wurde 2002 unter Federführung des IWS das erste EUV-Labor-Reflektometer in Europa aufgebaut. Das Gerät kann die beschichteten Spiegel mit EUV-Strahlung winkel- und energieabhängig vermessen und so die optischen Eigenschaften der Oberflächenbeschichtung bestimmen. All das war bis dahin normalerweise nur mit einer Synchrotron-Strahlungsquelle machbar. »Synchrotron-Strahlzeit an den Großforschungseinrichtungen ist extrem teuer und der Zugang ist begrenzt«, erklärt Peter Gawlitza die Nachteile. Das EUV-Reflektometer hingegen erzeugt die EUV-Strahlung mit einer Laserpuls-Plasma-Quelle im Labormaßstab und ist damit einfach, schnell und flexibel für die Metrologie der EUV-Spiegel verfügbar. Das erste EUV-Labor-Reflektometer ist auch heute, 18 Jahre später, noch in Benutzung und ständiges Werkzeug bei der Schichtentwicklung für EUV-Spiegel.
EUV-Mikroskop mit Schwarzschild-Objektiv
Auch abseits der Anwendung in der Halbleiter-Lithographie sind die neu entwickelten EUV-Beschichtungen für optische Geräte hochinteressant. So bauten Forscher des Fraunhofer IWS zusammen mit Kolleginnen und Kollegen vom Fraunhofer ILT auf Basis der gemeinsamen Ergebnisse 2004 ein EUV-Mikroskop auf, das mit EUV-Quelle, Kollektoroptik und Schwarzschild-Objektiv mehrere, speziell für diesen Wellenlängenbereich optimierte Komponenten enthält. Das Fraunhofer IWS war hier für die Reflexionsbeschichtungen der zylinderähnlichen Kollektoroptik und der beiden sphärischen Spiegel des Schwarzschild-Objektivs verantwortlich. Fortschritte bei den Poliermethoden der Spiegeloberflächen und deren Beschichtung ermöglichten so ein neuartiges Schwarzschild-Objektiv, speziell für EUV-Strahlung bei 13,5 Nanometern Lichtwellenlänge. Diese Art von Optik lässt sich wie in der Mikroskopie mit vergrößernder Abbildung eines Untersuchungsobjektes nutzen. Ebenso kann es aber auch umgedreht als verkleinernde Optik Verwendung finden, beispielsweise für die Fokussierung einer räumlich ausgedehnten EUV-Quelle auf Strukturen von wenigen Nanometer Größe.
Joseph-von-Fraunhofer-Preis belohnte die Mühen
Für die industrielle Umsetzung der EUV-Beschichtungstechnologie waren in den Folgejahren viele Entwicklungen zur Prozessstabilisierung und Skalierung auf große Spiegelgeometrien erforderlich. Das erste bedeutende Anlagenkonzept für die industrielle Beschichtung von EUV-Spiegeln entwarf das Fraunhofer IWS im Jahr 2010. Diese Anlage besaß dafür sechs lineare Beschichtungsquellen und konnte Spiegel mit einem Durchmesser von bis zu 600 Millimetern beschichten.
Die Mühen um die Weiterentwicklung der EUV-Technologie und die Konzeption von Prototypen für industrielle Anlagen zahlten sich 2012 aus, als das Fraunhofer IWS zusammen mit dem Fraunhofer IOF und dem Fraunhofer ILT mit dem Joseph-von-Fraunhofer-Preis für herausragende wissenschaftliche Leistungen ausgezeichnet wurden. Die damaligen drei Gruppenleiter für EUV-Lithographie – Dr. Stefan Braun vom IWS, Dr. Klaus Bergmann vom ILT und Dr. Torsten Feigl vom IOF – nahmen den Preis stellvertretend für ihre Institute dankend entgegen.
Weiterentwicklungen und Meilensteine nach 2015
Ab dem Jahr 2015 verzeichnete das Fraunhofer IWS weitere Meilensteine bei der Schichtentwicklung für die EUV-Lithographie: So übertraf es seinen eigenen Spitzenwert des Reflexionsgrades und erreichte den bis heute gültigen Weltrekord für EUV-Spiegel von 70,8 Prozent für 13,5 Nanometer Lichtwellenlänge bei senkrechter Reflexion. Gleichzeitig entwickelten sich die Anforderungen an die EUV-Lithographiesysteme rasant weiter, insbesondere werden die zu beschichtenden Flächen der Optiken größer und sind teilweise stark gekrümmt. Für Beschichtungen bedeutet das, dass präzise und steile Dickengradienten, z. T. auch über die Stapelhöhe variiert, aufgebracht werden müssen. Peter Gawlitza sagt dazu: »Die Übertragung der Beschichtungstechnologie auf große, komplizierte Oberflächen ist einer unserer Haupterfolge. Wir haben die Beschichtung großer Optiken seit 2015 deutlich weiterentwickelt, sodass wir nun auch asphärische oder unsymmetrische Spiegelflächen mit höchstem Reflexionsgrad herstellen können.«
Ziele und Entwicklungen
Die mit EUV-Lithographie hergestellten Mikrochips sind seit Ende 2018 in der Massenproduktion angekommen. Führende Smartphone-Hersteller brachten im Sommer 2019 die ersten Modelle mit EUV-belichteten Prozessoren auf den Markt. Diese Smartphones der neuesten Generation enthalten nun Prozessoren, die leistungsfähiger, energieeffizienter und schneller arbeiten als alle ihre Vorgänger. Und die Entwicklung ist noch lange nicht abgeschlossen: Weitere Strukturverkleinerungsschritte sind schon fest im Visier der weltweiten Lithographie-Forschung. Auch das Fraunhofer IWS betätigt sich weiterhin aktiv auf diesem Gebiet und beteiligt sich regelmäßig an nationalen und internationalen Projekten zur EUV-Lithographie, wie z. B. aktuell am EU-Projekt »TAPES3«. Die Partner befassen sich in diesem großen Verbundprojekt noch bis Ende 2021 mit der Lithographietechnologie für Strukturgrößen von drei Nanometern. »Die Belichtungsverfahren werden immer ausgefeilter, die Optiken entsprechend komplizierter und unregelmäßiger. Trotzdem müssen sie glatt und perfekt beschichtet sein – die Technologie dahin zu bringen, das ist unsere aktuelle Aufgabe«, konstatiert Peter Gawlitza. Die für den Zukunftspreis nominierten Teams haben auf ihren Spezialgebieten maßgeblich an der Weiterentwicklung der EUV-Lithographie mitgearbeitet. Dennoch: Die Forschung zu diesem Thema ist noch lange nicht abgeschlossen. EUV-Gruppenleiter Gawlitza freut sich über die seit der Nominierung gestiegene Wahrnehmung des Themas in der Öffentlichkeit. Das Fraunhofer IWS drückt allen Beteiligten die Daumen für die Preisverleihung.
 Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS
Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS