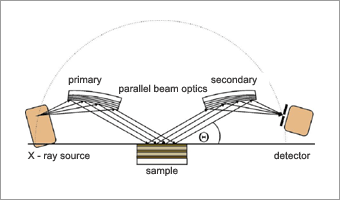
Messanordung mit zwei Parallelstrahloptiken, jeweils eine primär hinter der Quelle und eine sekundär vor der Detektorblende
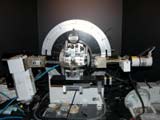
Goniometer des Messgerätes "D8" mit Quelle, Röntgenoptiken, Blenden, Probe und Detektor
Röntgenreflektometrie
Die Röntgenreflektometrie wird routinemäßig zur Analyse von dünnen Schichten mit Dicken im Bereich von d = 2 ... 250 nm eingesetzt. Je nach Anforderung können die Messungen mit Cu-, Mo-, Ag- oder Cr-K-Strahlung erfolgen. Die mit Röntgenreflektometrie zu erhaltenen Kenndaten sind:
- d: Dicke der Schichten
- ρ: Dichte von Einzelschichten oder mittlere Dichte von Multischichten
- σ: Grenzflächenweite (Rauheit, Interdiffusion) von Schichtübergängen
Um auch kleinste Schichtdickenunterschiede im Pikometerbereich bei verschiedenen Nanometer-Multischichten nachweisen zu können, wurden die beiden verfügbaren Röntgengeräte "D5005" und "D8" auf höchste Wiederholgenauigkeiten optimiert. Dies und hohe Intensitäten verbunden mit geringen Messzeiten erlauben präzise Messungen bei der Schichtentwicklung und leistungsstarke Qualitätkontrollen fertiger Optiken.
 Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS
Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS