UHV-Ionenstrahlsputteranlage zur Nanometer-Präzisions-beschichtung und -ätzung
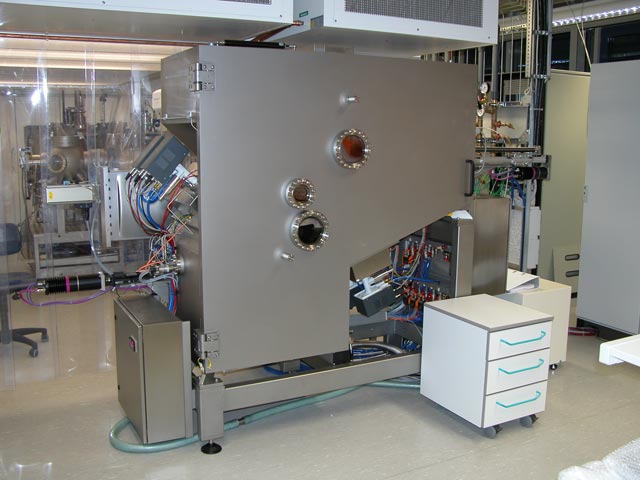
UHV-Ionenstrahlsputteranlage zur Nanometer-Präzisionsbeschichtung und -ätzung
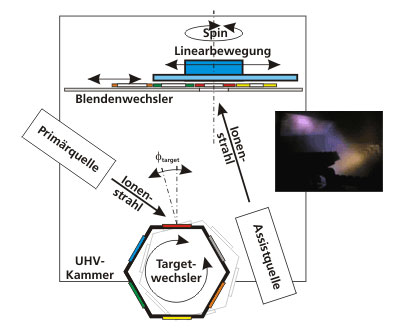
Prinzipskizze der geometrischen Anordnung von Ionenstrahlquellen, Targets und Substrat in der Ionenstrahl-Sputteranlage
Technische Daten
- Vakuum:
- Prozesskammer: p < 2·10-8 mbar
- Schleuse: p < 5·10-7 mbar
- Substrate:
- rund bis Ø = 200 mm
- rechteckig bis L = 500 mm (ohne Spin)
- Targets: 6 Stück, Größe: 400 x 200 mm2
- Ionenstrahlquellen:
- primär für Targetzerstäubung
- sekundär für Assist- und Ätzbetrieb
- Anregungsprinzip: ECR = Elektronenzyklotronresonanz
- Größe: 400 x 100 mm2
- Ionenenergien: E = 50 - 2000 eV
- Blenden:
- zur Strahlformung und Schichtdickenhomogenisierung
- 4 Stück, automatisch wechselbar
Einsatzgebiete
- Synthese von Nanometer-Einzel- und Multischichten für Röntgen- und EUV-Optiken
- Herstellung von dielektrischen Multischichten für Laseroptiken
Schichteigenschaften
- extrem geringe Mikrorauheiten im Bereich von σrms = 0,15 ... 0,3 nm
- Homogenität: 99,0 - 99,9 % über Ø 200 mm
- absorptionsfreie dielektrische Schichten im UV-IR-Spektralbereich
 Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS
Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS