
MSD-Prozess zur Beschichtung von Mo/Si-Multischichten
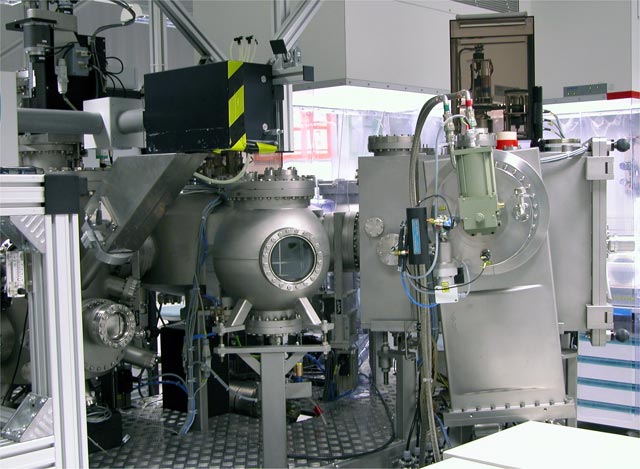
UHV-Clustertool zur Herstellung von Präzisions-Nanometer-Multischichten
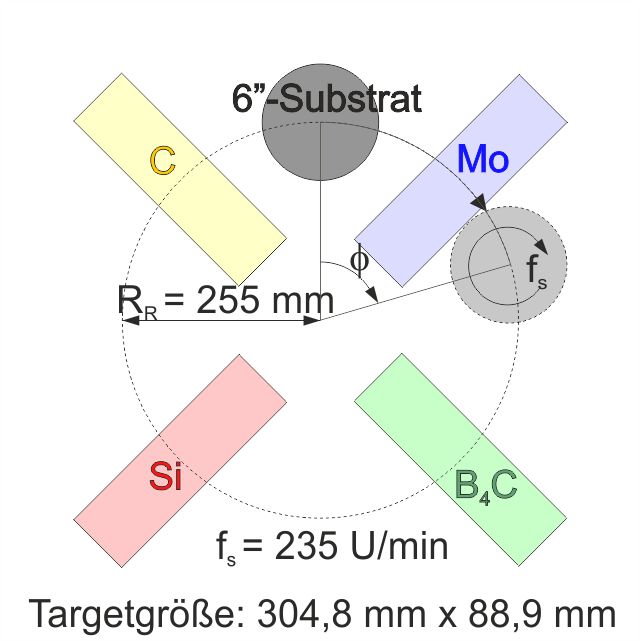
Schematische Darstellung der Target-Substrat-Anordnung
Prinzip der Schichterzeugung
- Plasmaerzeugung durch Stoßionisation
- statisches Magnetfeld zur Erhöhung der Plasmadichte
- Zerstäubung des Targetmaterials durch Stoßprozesse zwischen den Sputtergasionen und den Targetatomen
- Kondensation der zerstäubten Teilchen auf der Substratoberfläche
Prozessbedingungen
- Vakuum: p ~ 2 x 10-8 mbar
- Ar-Sputtergasdruck: p > 7 x 10-4 mbar
- Magnetronbetrieb: DC, RF für Reaktivprozesse
- Anzahl der Sputterquellen: 4
- Entladungsleistungen: < 1 kW
- Targetgröße: 304,8 mm x 88,9 mm (12'' x 3,5'')
- Substratgröße: schleusbar bis zu einem Durchmesser von 150 mm, größere Substrate bis zu einem Durchmesser von 250 mm werden per Hand über die Kammertür bestückt
- Target-Substrat-Abstand: 50 ... 100 mm
Vorteile der MSD
- hohe Beschichtungsraten
- sehr stabile, einfache und reproduzierbare Prozessführung
- sehr gute Schichthomogenitäten
- einfache Skalierbarkeit auf größere Substratgeometrien
Einsatzgebiete
- EUV-Reflexionsschichten (Mo/Si)
- röntgenoptische Multischichten (W/Si, W/B4C, Mo/B4C, ...)
- XUV-Reflexionsschichten (Cr/Sc, Sc/Si, Mo/Si, ...)
- Monochromatoren für die Röntgenfluoreszenzanalyse (W/Si, W/B4C, Mo/Si, Mo/B4C, Cr/Sc, Cr/C, ...)
- metallische Beschichtungen zur Verspiegelung (Al, Ag, ...)
- dielektrische Multischichten (SiO2/Al2O3, SiO2/TiO2, ...)
- Schichtdickennormale (Ru, Cu, Al, Ti, Cr, Si, C, B4C, Sc, Ag, ...)
 Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS
Fraunhofer-Institut für Werkstoff- und Strahltechnik IWS